CHAPITRE PREMIER
IMPLANTATION IONIQUE ET
FORMATION DES NANO-CAVITES
1.1 L'IMPLANTATION IONIQUE PAR FAISCEAU D'IONS
L'implantation ionique est utilisée depuis longtemps
dans l'industrie électronique. L'idée est de Schockley (un des
inventeurs du transistor) qui proposa l'implantation ionique pour le dopage des
semi-conducteurs dès 1951. A partir de 1971, le procédé
fut industrialisé pour la fabrication des circuits
intégrés. Proposé dès 1973 pour des applications
mécaniques, il fut rapidement utilisé avec succès. Des
applications ont vu le jour dans l'industrie mécanique,
aéronautique, biomédicale.
1.1.1 Définition
L'implantation ionique par faisceau d'ions est un
procédé d'ingénierie des matériaux. Comme son nom
l'indique elle consiste à modifier les propriétés d'un
matériau par l'insertion d'ions dans son volume. Il existe deux
processus d'implantation ionique : implantation par faisceau d'ions et
implantation par immersion plasma.
L'implantation ionique est également utilisée
dans l'industrie électronique pour la fabrication de certains composants
semi-conducteurs (microélectronique) et pour le traitement de la surface
des métaux. Les ions permettent à la fois de changer les
propriétés chimiques de la cible, mais également les
propriétés structurelles car la structure de la cible peut
être abîmée ou même détruite.
1.1.2 Principe
A partir d'une source gazeuse, solide ou liquide, contenant
l'atome à implanter, un plasma est créé 1. Un
champ électrique appliqué à la sortie de cette source
permet l'extraction des ions. Ce faisceau ionique traverse ensuite un champ
magnétique oil l'on sélectionne l'ion à implanter en
1. les ions que l'on souhaite implanter sont tout d'abord produit
à partir d'un gaz, qui est ionisé par bombardement
électronique.
fonction de sa masse atomique. Le faisceau est ensuite
accéléré, puis focalisé sur toute la surface de
l'échantillon.
La quantité de matériaux implantée,
appelée dose ou fluence est l'intégrale sur le temps du courant
ionique. Les courants électriques en jeu dans les implanteurs sont de
l'ordre du microampère. Ils ne permettent donc d'implanter qu'une faible
quantité d'ions. Cette technique n'est utilisée que dans les
domaines oil la modification recherchée est faible.
L'accélération des ions atteint typiquement des énergies
allant de 10 à 500 keV. Toutefois, il est possible de se limiter
à des énergies inférieures à 10 keV, mais dans ce
cas la pénétration ne dépasse jamais quelques
nanomètres. On trouve également des accélérateurs
qui sont capables d'accélérer des ions jusqu'à 5 MeV, mais
cela provoque des dégâts structurels importants de la cible. Par
ailleurs, étant donné que la distribution de la profondeur de
pénétration est large, le changement de composition en un point
donné est relativement faible car les profils de composition ne sont pas
toujours des gaussiennes parfaites : il peut y avoir une légère
déformation (ou asymétrie, kurtosis en anglais) rendant le profil
asymétrique (figure 1.2). Ces profils sont généralement
calculés avec le logiciel TRIM (Transport Range IMplantation), il nous
donne une idée de la distribution en profondeur des ions dans le
matériau.
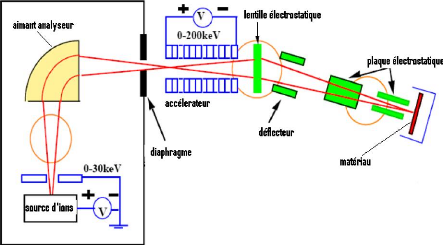
FIGURE 1.1: Schéma d'un implanteur par faisceau d'ions
[2]
Les ions dopants sont vaporisés, projetés sur le
matériau cible (porté à une certaine température)
dans lequel se produisent de nombreuses collisions. Ces ions subissent alors
une perte graduelle d'énergie, jusqu'à ce qu'ils s'arrêtent
à une profondeur. Ce traitement, qui utilise des faisceaux d'ions de
haute énergie, permet une profondeur moyenne de
pénétration des atomes allant de
100 Aÿ à 1 um. La profondeur moyenne
est contrôlée en ajustant l'énergie
d'accélération, et la dose d'impuretés implantées
est fixée par le courant ionique et la durée du balayage. Le
principal effet secondaire est la création des défauts ponctuels
ou étendus dans le matériau, dus principalement aux collisions
nucléaires. Afin d'éliminer ces défauts et aussi d'activer
les dopants par diffusion de ceux-ci en sites substitutionnels, un traitement
thermique (recuit) est ensuite nécessaire.

FIGURE 1.2: Profils d'implantation du Bore dans le silicium
[2]
1.1.3 Mécanismes physiques liés à
l'implantation ionique
Nous allons décrire dans ce paragraphe quelques
mécanismes mis en jeu au cours d'une implantation ionique. En effet en
pénétrant dans le solide, les ions perdent leur énergie
selon deux processus, comme le montre la figure 1.3 :
- Le freinage électronique, au cours duquel
l'énergie est transmise aux électrons; - Le freinage
nucléaire, dans lequel le transfert se fait aux atomes du solide.
| 


